xFD全称multi-dieface-down,是一种基于焊线(wirebond)的多die封装技术,将多颗DRAMIC以面朝下的方式封装在一颗芯片内,并采用类似windows-BGA封装的短焊线结构,号称:
-提升容量,整体元件尺寸比传统方案缩小25-35%,主要是垂直高度大大降低;
-增强电气性能,同时因为上下die性能均衡而可将良品率提升50-70%;
-比传统双die封装(DDP)热传输效率提升20-30%。
xFD技术现在有两种形式,一是“DFD”(DualFaceDown),单芯片封装两颗x4/x8/x16DRAMdie,其中x4/x8版本采用104BGA封装,尺寸11.5×11.5毫米,x16版本采用136BGA封装,尺寸11.5×11.5毫米或者11.5×14毫米。
二是“QFD”(QuadFaceDown),单芯片封装四颗x8/x15DRAMdie,256BGA封装,尺寸16.2×16.2毫米。
如果你担心这种封装下的内存性能的话,Invensas公司宣称其可在2133MHz高频率下运行,而且经过了完全调试和认证。
InvensasxFD封装技术主要面向服务器、数据中心、笔记本和其它移动设备,但何时能够出现在市面上还不得而知。

 2022年-中铁二十局集团有限公司雄商高铁站前七标项目经理部
2022年-中铁二十局集团有限公司雄商高铁站前七标项目经理部 2022年-陕西延长石油延安能源化工有限责任公司聚烯烃灌装
2022年-陕西延长石油延安能源化工有限责任公司聚烯烃灌装 2022年-麻家梁煤业有限责任公司工作面奥灰水地面区域治理
2022年-麻家梁煤业有限责任公司工作面奥灰水地面区域治理 2022年-亚洲基础设施投资银行贷款河南郑州等地特大暴
2022年-亚洲基础设施投资银行贷款河南郑州等地特大暴
 华润电力红安天明150MW风电项目220kV升压站PC工程
华润电力红安天明150MW风电项目220kV升压站PC工程 华润清远清新林泉扩建50MW风电项目主体施工工程招标公告
华润清远清新林泉扩建50MW风电项目主体施工工程招标公告 华润水泥合浦分布式光伏项目EPC工程总承包招标公告
华润水泥合浦分布式光伏项目EPC工程总承包招标公告 华润电力鲤鱼江电厂贮灰场环境治理及综合利用光伏项目110kV
华润电力鲤鱼江电厂贮灰场环境治理及综合利用光伏项目110kV 山西阳泉矿区泊里煤矿项目井底车场水仓、主排水泵房及主变电所掘
山西阳泉矿区泊里煤矿项目井底车场水仓、主排水泵房及主变电所掘 山西乡宁焦煤集团东沟煤业有限公司工业广场边坡项目治理工程总
山西乡宁焦煤集团东沟煤业有限公司工业广场边坡项目治理工程总 利用亚行贷款中国—东盟中小企业协同创新发展综合提升
利用亚行贷款中国—东盟中小企业协同创新发展综合提升 中铁二十局集团有限公司雄商高铁站前七标项目经理部粉煤灰
中铁二十局集团有限公司雄商高铁站前七标项目经理部粉煤灰 陕西延长石油延安能源化工有限责任公司聚烯烃灌装改造
陕西延长石油延安能源化工有限责任公司聚烯烃灌装改造 麻家梁煤业有限责任公司工作面奥灰水地面区域治理工程招标公告
麻家梁煤业有限责任公司工作面奥灰水地面区域治理工程招标公告 亚洲基础设施投资银行贷款河南郑州等地特大暴雨洪涝灾害灾后恢复
亚洲基础设施投资银行贷款河南郑州等地特大暴雨洪涝灾害灾后恢复 (2022年)鲁山豫能抽水蓄能有限公司河南鲁山抽水蓄能电站安
(2022年)鲁山豫能抽水蓄能有限公司河南鲁山抽水蓄能电站安 (2022年)海南新媒体绿都一期项目(西地块)电梯采购与安装
(2022年)海南新媒体绿都一期项目(西地块)电梯采购与安装 (2022年)同煤大唐塔山煤矿有限公司四盘区立井井筒装备安装
(2022年)同煤大唐塔山煤矿有限公司四盘区立井井筒装备安装 (2022年)亚洲开发银行贷款山西城乡水源保护和环境改善示范
(2022年)亚洲开发银行贷款山西城乡水源保护和环境改善示范 2022年-首钢股份公司迁安钢铁公司炼铁作业部烧结精
2022年-首钢股份公司迁安钢铁公司炼铁作业部烧结精 2022年-江苏省液化天然气储运调峰工程项目取排水工程施工
2022年-江苏省液化天然气储运调峰工程项目取排水工程施工 2022年-山西忻州神达万鑫安平煤业有限公司矿井兼并重组整合
2022年-山西忻州神达万鑫安平煤业有限公司矿井兼并重组整合 2022年-山西忻州神达原宁煤业有限公司90万吨/年矿井兼并
2022年-山西忻州神达原宁煤业有限公司90万吨/年矿井兼并 2022年-成庄矿选煤厂煤泥干燥系统改造工程招标公告
2022年-成庄矿选煤厂煤泥干燥系统改造工程招标公告 2022年-高青县春汇综合智能仓配物流园项目施工总承包
2022年-高青县春汇综合智能仓配物流园项目施工总承包 2022年-陕西中烟工业有限责任公司汉中卷烟厂卷包除尘
2022年-陕西中烟工业有限责任公司汉中卷烟厂卷包除尘 2022年-同煤大唐塔山煤矿有限公司煤泥烘干生产线清洁热源工
2022年-同煤大唐塔山煤矿有限公司煤泥烘干生产线清洁热源工 2022年-承德航天天启风光储氢一体化多能互补示范项目
2022年-承德航天天启风光储氢一体化多能互补示范项目 2022年-利用亚洲开发银行贷款农业综合开发长江绿色生态廊道
2022年-利用亚洲开发银行贷款农业综合开发长江绿色生态廊道 2022年-嵩县前河矿业有限责任公司葚沟矿区天井钻机工程
2022年-嵩县前河矿业有限责任公司葚沟矿区天井钻机工程 2022年-广东陆河抽水蓄能电站施工电源工程建设项目招标公告
2022年-广东陆河抽水蓄能电站施工电源工程建设项目招标公告 首钢股份公司迁安钢铁公司炼铁作业部烧结精3、返8通廊加固设计
首钢股份公司迁安钢铁公司炼铁作业部烧结精3、返8通廊加固设计 江苏省液化天然气储运调峰工程项目取排水工程施工招标公告
江苏省液化天然气储运调峰工程项目取排水工程施工招标公告 山西忻州神达万鑫安平煤业有限公司矿井兼并重组整合项目矿建工程
山西忻州神达万鑫安平煤业有限公司矿井兼并重组整合项目矿建工程 山西忻州神达原宁煤业有限公司90万吨/年矿井兼并重组整合项目
山西忻州神达原宁煤业有限公司90万吨/年矿井兼并重组整合项目 粉条机,宽粉机,凉皮机QQ2955625899
粉条机,宽粉机,凉皮机QQ2955625899 猪脾高速胶体磨
猪脾高速胶体磨 恒温恒湿的乐存乐库迷你仓与红酒更相配
恒温恒湿的乐存乐库迷你仓与红酒更相配 蒙阴县海南星月菩提批发|星月菩提厂家直销
蒙阴县海南星月菩提批发|星月菩提厂家直销 斩拌机视频,125斩拌机视频,斩拌机切肉视频
斩拌机视频,125斩拌机视频,斩拌机切肉视频 【寒冬●红酒●伏羲●壁炉】_欧壁火壁炉文化
【寒冬●红酒●伏羲●壁炉】_欧壁火壁炉文化 超声波全自动一拖三平面口罩本体机
超声波全自动一拖三平面口罩本体机 U型大容量腻子粉搅拌机 瓷砖胶生产设备
U型大容量腻子粉搅拌机 瓷砖胶生产设备 辽源地面打磨机 混凝土水磨石机 厂家直销
辽源地面打磨机 混凝土水磨石机 厂家直销 暖场表演,声势氛围
暖场表演,声势氛围 广东省东莞市幸运印花材料有限公司
广东省东莞市幸运印花材料有限公司 圆形冷却塔
圆形冷却塔 隔爆水袋 60L防爆水袋 隔爆水袋
隔爆水袋 60L防爆水袋 隔爆水袋 回收电子管
回收电子管 西门子
西门子 秦皇岛蓄排水板销售
秦皇岛蓄排水板销售 东营哪里回收钯碳
东营哪里回收钯碳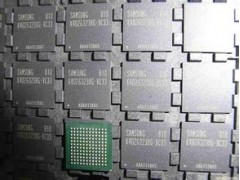 回收东芝内存芯片
回收东芝内存芯片 潮州回收巴斯夫染料18730013116
潮州回收巴斯夫染料18730013116 苏州回收氢化双酚A13931090048苗先生
苏州回收氢化双酚A13931090048苗先生 收购龙岗废塑料
收购龙岗废塑料 云浮过期的醇酸油漆回收公司15131074496
云浮过期的醇酸油漆回收公司15131074496 鲁山县供应进口发电机出租【收购】18513089999
鲁山县供应进口发电机出租【收购】18513089999 四川雅安有没有肉牛养殖场
四川雅安有没有肉牛养殖场 辽源市施耐德总代理总经销
辽源市施耐德总代理总经销 现在牧羊犬价格南昌市 15265773011
现在牧羊犬价格南昌市 15265773011 【钻机集尘器滤筒】_钻机集尘器滤筒批发价格【恒义】
【钻机集尘器滤筒】_钻机集尘器滤筒批发价格【恒义】 2020年+2021年广州广交会摊位订购书
2020年+2021年广州广交会摊位订购书 水质微生采样检测箱批量生产
水质微生采样检测箱批量生产 DTM10-502-A0-C0-E00-F00-G0-S0
DTM10-502-A0-C0-E00-F00-G0-S0 清远玻璃幕墙C型钢-墙面C型钢
清远玻璃幕墙C型钢-墙面C型钢


















